- 深圳萤美电子科技有限公司
 Copyright ©2008-2011 idusb.com All Rights Reserved
Copyright ©2008-2011 idusb.com All Rights Reserved - 地址:深圳市福田区福虹路国际科技大厦3605 备案号:粤ICP备2024181387号-1
- 电话:0755-88910635 23822265 23822252 23822683 传真:0755-23962251 Email:sales@linyic.com

您的位置:首页 > 企业新闻 > 智能手机硬件走“高”, 制造商DFX设计面临诸多新挑战
智能手机硬件走“高”, 制造商DFX设计面临诸多新挑战
随着智能手机的普及进程日渐推进,人们对智能手机的功能、外观等有了越来越多的要求,大触摸屏幕、超薄成了智能手机发展的主流方向。而这对手机制造商也提出了更大的挑战。在第八届中国手机制造技术论坛上,中兴通讯DFX总监余宏发就此问题进行了具体阐述。

中兴通讯DFX总监余宏发
目前,智能手机具备了普通手机的全部功能,并能无线接入互联网,同时,它也具有PDA的功能,可实现个人信息管理、日程任务安排等。除此之外,人性化的设计(时尚的造型、炫丽的界面、强大的功能和易扩展)和平民化的价格更是成了智能手机制造环节需要考虑的重中之重。
随着用户对智能手机的要求越来越多,智能手机对关键的硬件也提出了更高的要求:一是搭载高速的处理芯片,二是具有大存储芯片和存储扩展能力,三是有大的TP和LCD,四是大容量的电池。硬件的升级对智能手机的制造也提出了相应的挑战。
余宏发指出,由于手机的空间有限,大容量的电池必然导致单板越来越小,这就要求布局在单板上的器件越来越小,造成芯片贴装困难;其次,屏幕大、机身薄,组装的难度加大;第三,智能手机的功能多,这就导致生产测试周期长,拉低了效率。
结合实际情况,余宏发进一步对智能手机的典型制造问题进行了具体分析,并提出了相应的解决办法。
首先是POP焊接,POP即堆叠组装。对于智能手机来讲,为了减小体积,将信号处理芯片和存储芯片封装成一颗芯片。从堆叠焊接的发展来说,有两个常规的种类,PIP和POP。目前,业界普遍采用的是POP。虽然PIP封装的体积更小,但信号处理芯片和存储芯片的提供商必须是同一家厂商,终端厂商没有选择的自由,发挥的空间很小。此外,在封装之前,单个的芯片不可以单独测试,所以封装的良率很低,导致总成本会高。PIP是在底部元器件上面再放置元器件,外形高度虽然会稍微高些,但装配前的单个芯片可以单独测试,保障了更高的良率。另外,芯片的组合可以由终端厂商自由选择。因此,POP成了智能手机的优选装配方案。余宏发表示,由于POP的工艺制程,采用POP焊接目前普遍存在的问题可能是焊接开路或焊接短路,这可能是由于叠成翘曲或元器件封装过程中的变形,抑或回流过程中的热变形导致的。如何解决呢?可通过选择合适的器件(TSV、硅穿孔)、优化工艺参数、浸蘸焊膏、氮气回流等方法来应对。
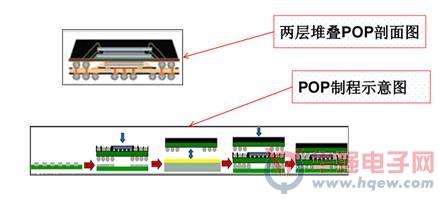
电话:0755-83005105/0755-82927935
联系人:陈先生/洪先生/陈小姐
公司地址:深圳市福田区福虹路世贸广场C座10楼1005
